導熱絕緣電子封裝材料檢視原始碼討論檢視歷史
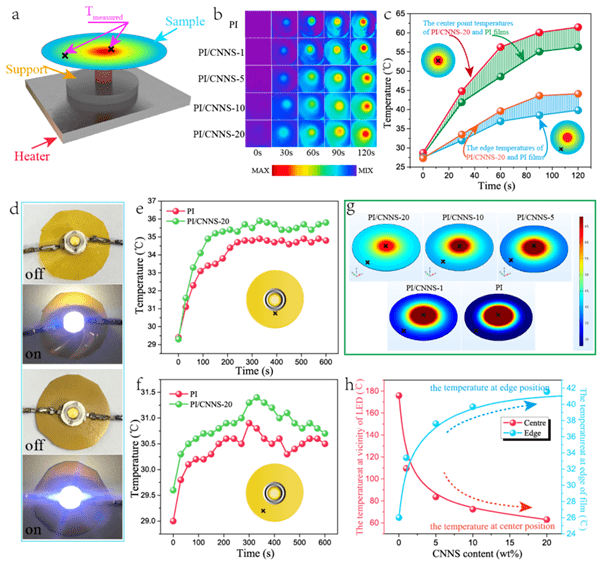 |
導熱絕緣電子封裝材料信息電子材料 、有機高分子材料 、複合材料 、材料失效與保護。
應用領域
印製電路芯片的封裝,電機、散熱器、傳感器線圈的絕緣層材料
成果簡介
集成電路的高集成化和小型化對電子封裝工藝及電子封裝材料提出了更高要求。Underfill(底部填充)是目前主流的電子封裝工藝,具有集成度高、功耗大、尺寸小、焊點多的特點。高散熱性能的導熱絕緣材料是高端芯片成功實施Underfill工藝封裝的關鍵。純環氧樹脂在常溫下的熱膨脹係數(CTE)為40~60 ppm/℃,其與常用的芯片材料硅(CTE為3.3 ppm/℃)與砷化鎵(CTE為5.8 ppm/℃)不匹配,易造成高度集成IC芯片的熱應力損壞;純環氧樹脂的導熱係數低,僅為0.14 W/(m.K)。採用自有專利技術製備的電子封裝材料,其CTE與硅等芯片材料處於同一數量級,導熱係數>1 W/(m.K)、電阻率高於1014Ω·cm,且具有低加工黏度(25℃的黏度< 20 Pa·s,滿足Underfill封裝工藝的要求)、高玻璃化溫度(>125℃)、低填充量、高模量等優點,滿足高端芯片封裝要求。
經濟效益與社會效益
微電子是世界支柱產業,集成電路(IC)是基石,電子封裝是IC產業鏈的關鍵環節,占IC總值的44%。我國目前高端電子封裝環氧樹脂基本依賴進口,採用自有技術生產的改性環氧樹脂封裝材料可取代部分進口產品,市場潛力大。同時,具有獨立知識產權[2]的製備技術可擺脫對國外產品和技術的依賴,具有顯著的社會效益。
參考文獻
- ↑ 什麼是環氧樹脂 ,搜狐,2021-11-17
- ↑ 什麼是知識產權?哪些屬於知識產權? ,搜狐,2018-06-28