BGA封装
| BGA封装 |
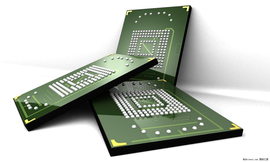 |
BGA封装90年代随着集成技术的进步、设备的改进和深亚微米技术的使用,LSI、VLSI、ULSI相继出现,硅单芯片集成度不断提高,对集成电路封装要求更加严格,I/O引脚数急剧增加,功耗也随之增大。为满足发展的需要,在原有封装品种基础上,又增添了新的品种--球栅阵列封装,简称BGA(Ball Grid Array Package)。
目录
简介
采用BGA技术封装的内存,可以使内存在体积不变的情况下内存容量提高两到三倍,BGA与TSOP相比,具有更小的体积,更好的散热性能和电性能。BGA封装技术使每平方英寸的存储量有了很大提升,采用BGA封装技术的内存产品在相同容量下,体积只有TSOP封装的三分之一;另外,与传统TSOP封装方式相比,BGA封装方式有更加快速和有效的散热途径。BGA封装的I/O端子以圆形或柱状焊点按阵列形式分布在封装下面,BGA技术的优点是I/O引脚数虽然增加了,但引脚间距并没有减小反而增加了,从而提高了组装成品率;虽然它的功耗增加,但BGA能用可控塌陷芯片法焊接,从而可以改善它的电热性能;厚度和重量都较以前的封装技术有所减少;寄生参数(电流大幅度变化时,引起输出电压扰动)减小,信号传输延迟小,使用频率大大提高;组装可用共面焊接,可靠性高。
评价
随着集成电路技术的发展,对集成电路的封装要求更加严格。这是因为封装技术关系到产品的功能性,当IC的频率超过100MHz时,传统封装方式可能会产生所的"CrossTalk"现象,而且当IC的管脚数大于208 Pin时,传统的封装方式有其困难度。因此,除使用QFP封装方式外,现今大多数的高脚数芯片(如图形芯片与芯片组等)皆转而使用BGA(Ball Grid Array Package)封装技术。BGA一出现便成为CPU、主板上南/北桥芯片等高密度、高性能、多引脚封装的最佳选择。[1]